中國粉體網訊 碳化硅是當下最為火熱的賽道之一,據不完全統計,僅在2022年,國內新立項/簽約的碳化硅項目就超過20個,總投資規模超過476億元。其中,設備作為碳化硅產業鏈中的重要一環,正在飛速發展。
事實上,國內在材料生長、切磨拋裝備和表征設備等方面都需要依賴進口,部分設備型號及更新速度嚴重受限于其他國家的政策,導致國內廠商生產成本居高不下,產能供給有限,且技術能力也落后于國際先進水平,裝備國產化勢在必行。(在此背景下,中國粉體網將于2023年6月14日在江蘇蘇州舉辦第二屆半導體行業用陶瓷材料技術研討會,屆時,來自中國電子科技集團公司第四十八研究所的高級工程師楊金將帶來題為《碳化硅芯片關鍵裝備及高性能陶瓷零部件國產化應用》的報告,歡迎報名參會)。
SiC產業鏈關鍵環節及工藝特點
SiC產業鏈關鍵環節
SiC器件產業鏈與傳統半導體類似,一般分為單晶襯底、外延、芯片、封裝、模組及應用環節。

SiC單晶襯底環節通常涉及到高純碳化硅粉體制備、單晶生長、晶體切割研磨和拋光等工序過程,完成向下游的襯底供貨。
SiC外延環節則比較單一,主要完成在襯底上進行外延層的制備,采用外延層厚度作為產品的不同系列供貨,不同厚度對應不同耐壓等級的器件規格,通常為1μm對應100V左右。
SiC芯片制備環節負責芯片制造,涉及流程較長,以IDM模式較為普遍。
SiC器件封裝環節主要進行芯片固定、引線封裝,解決散熱和可靠性等問題,相對來講國內發展較為成熟,由此完成SiC器件的制備,下一步進入系統產品和應用環節。
SiC工藝及設備特點
由于SiC材料具備高硬度、高熔點、高密度等特性,在材料和芯片制備過程中,存在一些制造工藝的特殊性,如單晶采用物理氣相傳輸法(升華法),襯底切磨拋加工過程非常緩慢,外延生長所需溫度極高且工藝窗口很小,芯片制程工藝也需要高溫高能設備制備等。
碳化硅器件生產各工藝環節關鍵設備

由于SiC工藝的特殊性,傳統用于Si基功率器件制備的設備已不能滿足需求,需要增加一些專用的設備作為支撐,如材料制備中的碳化硅單晶生長爐、金剛線多線切割機設備,芯片制程中的高溫高能離子注入、退火激活、柵氧制備等設備。在圖形化、刻蝕、化學掩膜沉積、金屬鍍膜等工藝段,只需在現有設備上調整參數,基本上可以兼容適用。
關鍵裝備一覽
SiC單晶生長設備
SiC單晶生長主要有物理氣相運輸法(PVT)、高溫化學氣相沉積法和溶液轉移法。目前產業上主要以PVT方法為主,PVT方法主要是將高純的SiC粉末在高溫和極低真空下進行加熱升華,在頂部籽晶上凝結成固定取向晶格結構的單晶,這種方法目前發展較為成熟,但生產較為緩慢,產能有限。

圖片來源:天科合達
采用PTV法生長碳化硅晶體的設備為長晶爐,該設備在保證滿足設計技術要求基礎上,還要注意到長晶爐部件在碳化硅晶體生長中經歷的苛刻條件,例如:晶體生長室及石墨坩堝等熱場核心組件需具備承受2500℃高溫的能力;長晶爐加工制作工藝的精密要求,即要求反應室及爐體具有優異的密封性和隔熱性,等等。正是這些原因,致使長晶爐的結構和設計變得極其復雜。
SiC襯底加工設備
切割設備
當前有兩種工藝方式:一是采用金剛線多線切割機切割后再進行研磨,另外一種采用激光輻照剝離技術后進行表面處理。多線切割工藝方式是目前最常用的方式。
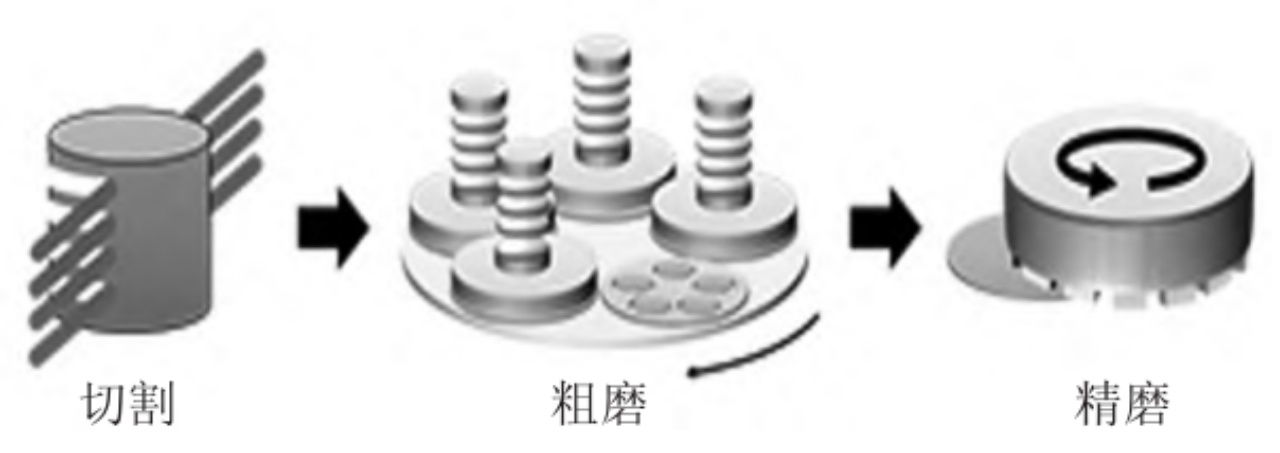
多線切割工藝原理

圖片來源:湖南宇晶
國際上SiC晶體切割設備廠家以瑞士的梅耶伯格(Meyer Buger)和日本的高鳥(Takatori)公司為代表,目前線速度水平都能夠達到2400m/min,根據工藝需求甚至還能達到更高。國內主要設備廠家包括中國電子科技集團公司第四十五研究所、唐山晶玉和湖南宇晶等,國產設備在切割效率、加工精度、可靠性和工藝成套性等方面與國外設備有一定差距,100~150mmSiC晶體切割設備線速度水平只能達到1500m/min。
倒角設備
目前倒角設備國際上主要供應商有日本東京精密和Daitron,其中東京精密半導體倒角機在行業內技術先進,已經形成W-GM系列全自動晶圓倒角機,市場占有率達90%以上。國內從事半導體晶圓倒角設備研制的企業有中國電子科技集團公司第二研究所和北京科翰龍半導體公司。中國電子科技集團公司第二研究所目前已成功研發DJJ-120和DJJ-120A兩款倒角機型,可以滿足50~100mm半導體晶圓的倒角工藝,建立了砷化鎵、銻化銦和碲鋅鎘等半導體晶圓的倒角工藝知識庫,自動化程度和倒角精度等均達到東京精密相同的水平。

圖片來源:中國電子科技集團公司第二研究所
磨拋設備
碳化硅的磨拋設備分為粗磨和細磨設備,粗磨方面國產設備基本可以滿足加工需求,但是細磨方面主要采購來自于日本不二越、英國log-itech、日本disco等公司的設備,采用設備與工藝打包銷售的方式,極大的增加了工藝廠商的使用成本和維護成本。國內的碳化硅磨拋設備廠商主要包括中國電子科技集團公司第四十五研究所、深圳東榮和浙江名正。

圖片來源:中國電子科技集團公司第四十五研究所
SiC外延生長設備
SiC芯片一般首先在4H-SiC襯底上再生長一層高質量低缺陷的4H-SiC外延層,其厚度決定器件的耐壓強度,設備為SiC外延生長爐,該工藝生長溫度需要達到最高1700℃,還涉及到多種復雜氣氛環境,這對設備結構設計和控制帶來很大的挑戰。
國際上主流的商用SiC材料同質外延生長設備機型分別為德國Aixtron公司的G5WW機型、意大利LPE公司的PE1O6機型和日本Nuflare公司EPIREVOTM S6機型,均能夠滿足100~150mmSiC晶片的外延生長工藝。
SiC芯片制程設備
SiC功率芯片的制造工藝流程基本與Si基功率器件類似,需要經過清洗、光刻、沉積、注入、退火、氧化、鈍化隔離、金屬化等工藝流程。在工藝設備方面,主要涉及清洗機、光刻機、刻蝕設備、LPCVD、蒸鍍等常規設備以及高溫高能離子注入機、高溫退火爐、高溫氧化爐等特殊專用設備。
SiC高溫高能離子注入機
在SiC生產線中,高溫高能離子注入設備是衡量生產線是否具備SiC芯片制造能力的一個標志;當前應用較為主流的設備主要有M56700-2/UM、IH-860D/PSIC和IMPHEAT等機型。

圖片來源:中電科電子裝備集團有限公司
SiC高溫退火設備
SiC注入完成后,需要采用退火方式進行離子激活和晶格損傷處理。設備需要最高溫度達2000℃,恒溫區均勻性≤±5℃的半導體爐管設備。SiC高溫退火國內應用較為成熟的設備有R2120-3/UM、Activator150、AileSiC-200等。

圖片來源:北方華創
SiC高溫氧化設備
SiC氧化溫度通常在1300~1400℃下進行,伴隨氧氣、二氯乙烯(DCE)、一氧化氮等復雜氣氛環境,常規的石英管式爐已不能滿足適用,現主流方式采用專用的加熱爐體設計,配套高純碳化硅材料工藝爐管,實現具有高溫高潔凈耐腐蝕反應腔的SiC高溫氧化爐設計。SiC高溫氧化國內應用較為成熟的設備有Ox-idSiC-650、M5014-3/UM和Oxidation150等。

圖片來源:中電科電子裝備集團有限公司
此外,在圖形化、刻蝕、金屬化等工藝設備方面,多個成熟的Si工藝已成功轉移到SiC。然而碳化硅材料特性需要開發特定的工藝,其參數必須優化和調整,在設備方面只需做微小的改動或定制功能開發。
清洗設備
清洗工藝是半導體制程的重要環節,也是影響半導體器件良率的重要因素,目前國際上以東京電子和迪恩士(DNS)為代表的清洗設備廠商可以穩定PRE(去除顆粒效果)做到45~28nm。盛美半導體作為國內單片清洗設備先進企業可以穩定在45nm工藝節點且在國際大廠已成功應用。國內其他清洗設備廠商包括中國電子科技集團公司第四十五研究所、北方華創和至純科技等。
小結
據Yole預測,2025年全球碳化硅功率半導體市場規模將達到25.62億美元,2019-2025年均復合增長率超過30%。隨著SiC產業快速發展和自主化需求,裝備國產化勢在必行、成長空間巨大。國內在襯底、外延、芯片等方面產業布局基本成型,但在關鍵裝備方面與國外仍存在差距,處于跟跑狀態;SiC需要解決高成本和高可靠性問題,大尺寸、高效能、低損傷及新工藝方法是未來行業設備發展的趨勢。
參考來源:
[1]楊金等.第三代半導體SiC芯片關鍵裝備現狀及發展趨勢
[2]周哲等.碳化硅材料裝備技術現狀
[3]產業加速擴張之下,碳化硅設備成入局“香餑餑”.集微網
[4]一張圖了解生產碳化硅晶片的靈魂裝備——長晶爐.粉體網

(中國粉體網編輯整理/山川)
注:圖片非商業用途,存在侵權告知刪除


















