中國粉體網訊
化學機械拋光技術是半導體晶片表面加工的關鍵技術之一。該技術綜合了拋光液的化學腐蝕作用和磨粒及拋光墊的機械去除作用,以實現拋光后工件表面的良好質量、無損傷和高面形精度。
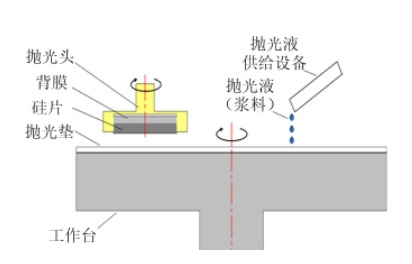
徐嘉慧等,硅片化學機械拋光技術的研究進展
從2000年至今,隨著IC制造技術節點的不斷延伸,CMP工藝逐漸朝著低K介質、低壓力、鈷互連技術、釕阻擋層等方面發展。
就CMP技術本身而言,有幾個關鍵節點。
從0.35~0.25μm技術節點開始,CMP技術成為唯一可實現全局平坦化的IC關鍵技術。0.18~0.13μm技術節點,由于銅正式取代鋁成為主流導線材料,使CMP成為銅互連技術必不可少的工藝制程。當技術節點發展到65nm時,用于減小RC延遲時間而引入的低K介質材料,逐步取代傳統的SiO2,傳統的CMP技術由于較高的壓力容易導致低K材料的塌陷或剝落,致使傳統的CMP很難應用于65nm節點以下,為此,開發低壓力、低K介質材料適用的CMP設備成為新的發展方向。
當技術節點發展到30~20nm時,Cu互連不再適用于20nm以下的互連技術,迫使人們開始研發新的互連材料及互連技術,應用于鈷互連技術的CMP技術成為又一發展方向。當集成電路節點發展到14nm時,CMP發展成為實現新的工藝技術如鰭式場效應晶體管(FinFET)、硅通孔技術(TSV)的關鍵技術。
7nm制程芯片需要30余道CMP拋光處理
隨著芯片制程的不斷縮小,CMP工藝在半導體生產流程中的應用次數逐步增加,以邏輯芯片為例,65nm制程芯片需經歷約12道CMP步驟,而7nm制程芯片所需的CMP處理則增加為30余道,CMP技術應用將更為頻繁。

CMP拋光步驟隨制程變化情況
CMP拋光工藝所處環節
半導體制造過程是一系列復雜且高度專業化的步驟,將原材料轉化為功能性電子組件。這個過程涉及多種技術和工藝,每個階段都需要精確控制和細致入微的關注。其主要工藝流程包括晶圓制備、清洗、蒸鍍、光刻、蝕刻、擴散、退火、電鍍、切割等,但涉及到具體步驟遠不止此。

半導體制造工藝流程
(1)芯片制造前端制程
硅晶圓材料制造過程主要可分為拉晶、切割、研磨、拋光、清洗等。晶圓制備中,CMP技術用于初始平坦化。晶圓因晶體生長和切割等工藝表面不平整,CMP可將其打磨平整,為光刻、刻蝕等后續工藝提供理想起始平面。

晶圓材料制造環節示意圖
(2)半導體制造環節
在半導體制造環節,半導體制造過程按照技術分工主要可分為薄膜沉積、CMP、光刻及顯影、刻蝕、離子注入等工藝,半導體制造中的CMP工藝環節是重要環節。在現代芯片多層金屬布線制造中,每層金屬布線完成后需CMP技術平坦化,為下一層布線提供平坦表面。這如同建造高樓大廈時每層地面需平整夯實,否則會出現短路、信號傳輸延遲等問題,影響芯片性能。
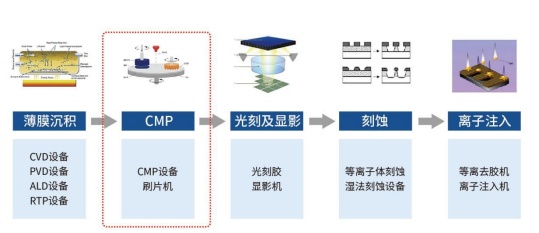
半導體制造環節示意圖
(3)芯片制造后端制程
在芯片封裝過程中,CMP技術可精確控制晶圓厚度,滿足封裝厚度要求。在扇出型封裝和系統級封裝等特殊封裝結構中,也用于平坦化封裝表面,提高封裝質量和性能。

先進封裝測試環節示意圖
CMP拋光工藝在半導體中的具體應用
(1)淺溝槽隔離(STI)
淺溝槽隔離(STI)是集成電路中實現不同區域電學特性精確處理的核心技術。其過程是在硅片上精心刻蝕出淺溝槽,隨后填充氧化硅,從而構建起電氣隔離層。
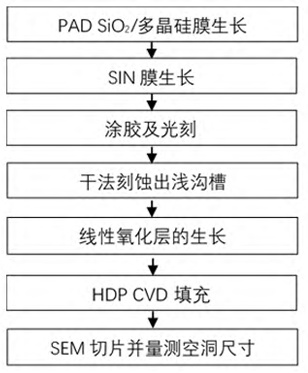
郭國超等,淺溝槽隔離填充的工藝優化分析
在此工藝里,CMP擔當著至關重要的角色。隨著芯片集成度的不斷攀升,對隔離層的精度與平整度要求近乎苛刻。CMP技術的應用,能夠精準去除溝槽中多余的氧化硅,實現晶圓表面的高度平坦化。
(2)多晶硅平坦化
多晶硅在半導體器件中廣泛應用,而多晶硅平坦化(Poly CMP)則是確保其性能的關鍵步驟。多晶硅層在沉積過程中,不可避免地會出現表面不平整現象。這些微觀的起伏,在后續的光刻和刻蝕等關鍵工藝步驟中,猶如隱藏的“陷阱”,可能導致圖案轉移偏差、器件尺寸不一致等問題,進而嚴重影響器件性能與生產良率。
Poly CMP技術通過精確控制研磨參數,去除多晶硅層表面的不平整部分,使表面達到近乎鏡面的平整度。這就好比為后續工藝鋪設了一條平坦的“高速公路”,光刻光線能夠準確無誤地投射到預定位置,刻蝕過程也能沿著精確的路徑進行,從而確保了器件尺寸的精確性和一致性,為高性能芯片的制造奠定了堅實基礎。
(3)層間介質平坦化(ILD CMP)
在半導體制造的復雜架構中,層間介質(ILD)平坦化是連接各個功能層的關鍵橋梁。隨著芯片朝著更高集成度和更小尺寸發展,多層互連線結構變得愈發復雜。ILD平坦化的重要性也隨之凸顯。
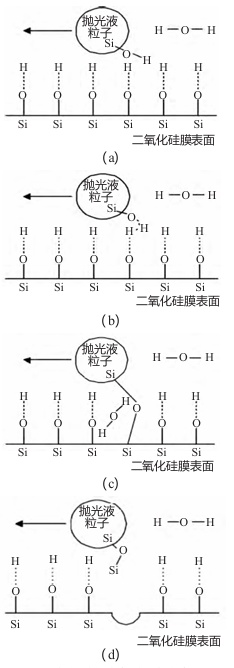
二氧化硅化學機械平坦化機理
詹陽等,層間介質(ILD)CMP工藝分析
ILD CMP的主要任務是確保晶圓表面達到高度平坦化,為后續的多層互連線工藝打造完美的“畫布”。一個平坦的表面對于光刻和刻蝕工藝的精度提升至關重要。在光刻過程中,平坦的表面能夠保證光刻膠均勻涂覆,光線透過掩膜版時不會因表面起伏而產生折射偏差,從而使圖案精確轉移到晶圓上。而在刻蝕階段,平整的表面有助于刻蝕劑均勻作用,減少因表面不平整導致的刻蝕過度或不足等缺陷。通過ILD CMP,有效提高了器件的性能和良率,使得芯片能夠在有限的空間內實現更多功能的集成。
(4)金屬間介質平坦化(IMD CMP)
金屬間介質平坦化面臨著更為復雜的局面,因為它需要同時處理多種材料,如二氧化硅、氮化硅等。不同材料的物理和化學性質差異,給CMP工藝帶來了巨大挑戰。例如,不同材料的硬度、化學反應活性不同,在研磨過程中需要精確控制研磨速率和選擇性,以確保各種材料都能得到適當的處理,同時保持表面的平整度。
此外,金屬間介質的表面不平整性對于后續的Al CMP也是一個棘手的問題。如果介電層(SiO2)的凹陷過大,在Al CMP后極易留下鋁的殘留,這如同在電路中埋下了一顆“定時炸彈”,隨時可能引發金屬短路等嚴重故障,導致芯片失效。因此,IMD CMP工藝需要不斷優化,采用先進的研磨液配方和工藝控制技術,在多種材料之間尋求平衡,確保金屬間介質的高質量平坦化,為后續的金屬布線工藝提供可靠保障。
(5)銅互連平坦化(Cu CMP)
銅互連技術作為現代半導體制造的核心技術之一,憑借銅的低電阻率和高導電性,為實現多層布線結構中的高效電氣連接提供了可能。然而,銅的加工面臨著獨特的挑戰。由于銅的化學刻蝕較為困難,其對應的化學反應產物揮發性較差,傳統的刻蝕方法難以奏效。因此,銅的圖形化通常采用大馬士革工藝,即先刻蝕介質形成圖形,然后再電鍍銅填充。
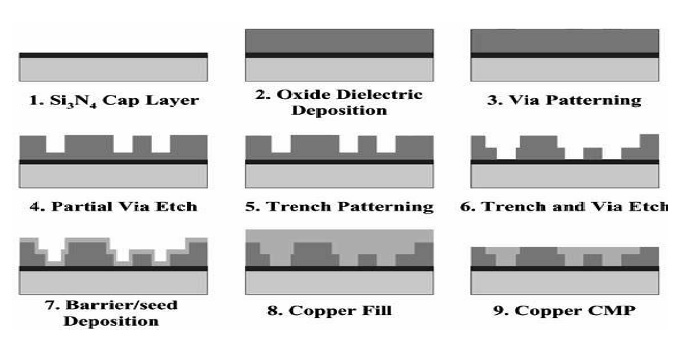
杜志友,關于銅互連化學機械拋光液的技術研究
在大馬士革工藝的最后,Cu CMP成為完成平坦化的關鍵一步。但銅的化學性質活潑,在空氣中極易氧化,且其硬度較低,這使得平坦化過程猶如在“鋼絲上跳舞”,需要格外小心。為了克服這些困難,研究人員開發了專門的研磨液和工藝條件,既能有效去除多余的銅,實現表面平坦化,又能防止銅的氧化,同時避免對銅層造成過度損傷。Cu CMP的成功應用,使得銅互連技術得以廣泛應用,推動了半導體制造向更高性能、更低功耗的方向發展。
化學機械研磨(CMP)技術在半導體制造的各個關鍵場景中都發揮著不可替代的作用。從淺溝槽隔離的精準控制,到多晶硅、層間介質、金屬間介質以及銅互連的平坦化處理,CMP技術不斷突破材料與工藝的限制,為半導體產業的持續創新與發展注入了強大動力。
參考來源:
[1] 中國粉體網、晶格半導體
[2] 孫興漢等,碳化硅化學機械拋光中材料去除非均勻性研究進展
[3] 徐嘉慧等,硅片化學機械拋光技術的研究進展
[4] 郭國超等,淺溝槽隔離填充的工藝優化分析
[5] 詹陽等,層間介質(ILD)CMP工藝分析
[6] 杜志友,關于銅互連化學機械拋光液的技術研究
(中國粉體網編輯整理/山林)
注:圖片非商業用途,存在侵權告知刪除!



















