中國粉體網訊 自20世紀80年代開始,電子元器件中電路的集成程度以每年1.5倍甚至更快的速度進行增長。集成電路的集成程度越來越高使電流越來越高,在工作中產生的熱量越來越大。如果散熱不及時,就會造成電子元器件的熱損壞并降低使用壽命。
所以,為了滿足日益增長的電子元器件散熱要求,具有高導熱性能的電子封裝材料被不斷地研究和優化。

金剛石/銅復合材料,圖片來源:元素六
01.金剛石與銅
傳統的電子封裝材料主要有陶瓷、塑料、金屬及其合金。BeO、AlN等陶瓷材料具有和半導體元器件相匹配的低熱膨脹系數,化學穩定性好,熱導率較高,但其制備工藝復雜,加工較困難,尤其是BeO有劇毒且成本高。塑料封裝材料具有成本低、質量輕、絕緣性好等優點,但塑料封裝材料熱導率差,耐高溫性差,電性能與半導體熱膨脹系數匹配一般。單一的Cu、Ag、Al等金屬具有較高的熱導率,但熱膨脹率過高。Cu-W,Cu-Mo等合金材料熱導率又較低。因此,為保障電子元器件的正常使用以及延長使用壽命,迫切需要研制熱導率高且熱膨脹率適宜的新型封裝材料。
各種增強體性能指標

金剛石是目前已知的在自然界中存在的最堅硬的物質,莫氏硬度達到10,同時也是自然界中導熱系數最高的物質之一,導熱系數高達200~2200W/(m·K)。

金剛石微粉,來源:元素六
銅的導熱、導電、延展性都較好,熱導率為401W/(m·K),遠高于鋁、鉬等金屬,并且價格低廉,被廣泛應用于集成電路領域。
綜合金剛石和銅的導熱性能,以銅為基體、金剛石為增強體的金剛石/銅復合材料被很多人認為是未來主流的高導熱電子封裝材料。
02.制備方法有講究
金剛石/銅常用的制備方法有:粉末冶金法、高溫高壓法、熔體浸滲法、放電等離子燒結法、冷噴涂法等。
單粒徑金剛石/銅復合材料不同制備方法工藝與性能對比

(1)粉末冶金法
該工藝基本原理是將金剛石顆粒和Cu基粉末按照預備的含量均勻混合,在混合的過程中可摻雜一定含量的粘結劑和成形劑,將混合粉體及摻雜劑壓制成型之后,通過燒結最終得到高導熱金剛石/Cu復合材料。

燒結設備
粉末冶金法工藝簡單,成本較低,是一種較成熟的燒結工藝。但該方法所得的粉體致密度不高、內部組織不均,且制得樣品尺寸有限、形狀簡單,難以直接制得熱學性能優異的熱導材料。
(2)高溫高壓法
高溫高壓法主要依靠六面頂壓機提供的高溫高壓對金剛石和銅進行燒結。所提供的高溫達到了銅的熔點,使得銅成為熔融狀態,另外由于金剛石的網格結構,在高溫高壓的作用下,熔融銅充分填充到金剛石網格結構周圍,形成了結合緊密的復合材料。

六面頂壓機
雖然高溫高壓法制備的復合材料致密度很高,導熱性能好,但是它對模具的要求很高,且難以制備尺寸較大的產品,成本較高,很難在工業上廣泛應用。
(3)熔體浸滲法
熔體浸滲顧名思義是將熔融態的金屬基體滲入增強體中即金剛石顆粒的間隙中,然后冷卻凝固制備復合材料。熔體浸滲法分為壓力、無壓浸滲2種。壓力、無壓浸滲均通過高溫使固態的銅達到熔點熔化。壓力浸滲通過施加外來的壓力使熔化的銅浸入金剛石的間隙中,無壓浸滲則是依靠金剛石顆粒自身的毛細現象驅動熔融銅滲入。用這種方法制成的復合材料熱導率均在446W/(m·K)以上。
(4)放電等離子燒結法
放電等離子燒結法(SPS)是將金剛石和銅的混合粉末裝入石墨模具中,利用脈沖電流產生火花放電溫度對粉末進行均勻加熱,同時在加熱過程中施加一定的壓力,實現快速燒結完成復合材料。它是一種新型、快速、高效的制備方法。
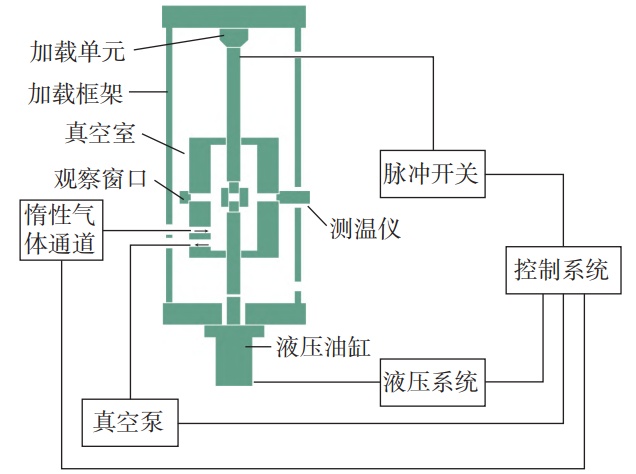
放電等離子燒結系統示意圖
放電等離子燒結法效率很高,但該法對金剛石體積分數要求較高,當金剛石體積分數高于65%時,燒結制備的復合材料性能大幅下降。
(5)冷噴涂法
冷噴涂沉積法是通過把兩種混好的粉末放入到爐膛中,經過金屬熔融、液態金屬霧化過程后噴射沉積在基體板上得到復合材料。
目前采用冷噴射沉積技術來制備金剛石復合材料的文獻不多,主要受設備限制,因此還有許多問題有待解決,如采用噴射沉積法制備出來的金剛石復合材料,其表面平整度是否可控,其熱導率能否滿足電子封裝要求等。
03.重要的事情說三遍:改性!改性!改性!
對復合材料的制備而言,組元之間相互浸潤是進行復合的必要先行條件,是影響界面結構及界面結合狀態的重要因素。金剛石和Cu的界面互不潤濕狀況導致界面熱阻很高。因此,通過各種技術手段對兩者的界面進行改性研究十分關鍵。目前,主要有兩種方法改善金剛石與Cu基之間的界面問題:(1)金剛石表面改性處理;(2)銅基體的合金化處理。

改性示意圖:(a)金剛石表面直接鍍覆;(b)基體合金化
(1)金剛石表面改性
在增強相表層鍍Mo、Ti、W、Cr等活性元素可改善金剛石界面特性,從而提高其熱傳導性能。通過燒結可使以上元素與金剛石粉體表層的碳反應形成碳化物過渡層,這樣優化了金剛石與金屬基之間的潤濕狀態,并且鍍層在高溫下可防止金剛石結構發生改變。
(2)銅基體合金化
在材料的復合加工之前,對金屬銅進行預合金化處理,這樣可制得熱導率普遍較高的復合材料。在銅基體中摻雜活性元素不僅可有效降低金剛石與銅之間的潤濕角,還能在反應后于金剛石/Cu界面間生成可固溶于銅基的碳化物層,這樣材料界面間存在的多數間隙得到修飾填充,從而提高了導熱性能。
小結
隨著社會的發展和進步,電子芯片產生的熱量日益增加,傳統封裝材料由于低熱導率或高熱膨脹系數的原因,已經很難滿足使用要求。而金剛石顆粒增強銅基復合材料具有高導熱性和可調控的熱膨脹系數等優點,被認為是具有發展前景的電子封裝材料之一。
參考來源:
[1]吳新志.金剛石表面處理對金剛石/銅復合材料導熱性能的影響
[2]衛陳龍.金剛石表面金屬化及金剛石/銅復合材料微波燒結工藝研究
[3]陳衛等.金剛石/銅復合材料的制備方法及應用現狀
[4]彭卓豪等.高導熱金剛石/Cu復合材料研究進展
[5]徐薇等.電子封裝用高導熱金剛石/銅復合材料的研究進展
[6]孫龍.金剛石/銅復合材料的制備及其性能研究
(中國粉體網/山川)
注:圖片非商業用途,存在侵權告知刪除


















