中國粉體網訊 半導體封裝,指用特定材料、工藝技術將芯片密封在塑料、金屬或陶瓷等材料制成的封裝體內,從而保護芯片免受物理性和化學性損壞,通過封裝,還可以使芯片能夠與其他電子元件進行連接,實現信息的輸入輸出。半導體封裝主要有機械保護、電氣連接、機械連接和散熱四大功能,芯片封裝完成后,需要進行性能測試,以確保封裝的芯片符合性能要求。
半導體封裝的四大作用
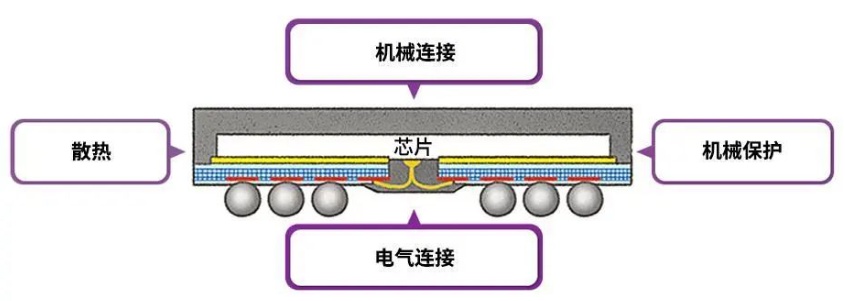
來源:海力士官網、HANOL出版社、山西證券研究所
LTCC和HTCC應用:各有所長
現今集成電路晶圓的特征線寬進入微納電子時代,而電子產品和電子系統的微小型化依賴先進電子封裝技術的進步,封裝技術已成為半導體行業關注的焦點之一。
LTCC和HTCC是兩種重要的半導體封裝技術,廣泛應用于半導體芯片封裝、MCM和SiP模塊制造。
LTCC封裝能將不同種類的芯片等元器件組裝集成于同一封裝體內以實現系統的某些功能,是實現系統小型化、集成化、多功能化和高可靠性的重要手段;HTCC技術在制作高精度、高密度的多層布線方面也具有較強的能力,能夠滿足半導體封裝對精細電路布局的需求。

LTCC技術和HTCC技術對比
LTCC即低溫共燒結陶瓷,LTCC基板具有布線導體方阻小、可布線層數多、布線密度高、燒結溫度低、介質損耗小、高頻性能優異、熱膨脹系數與多種芯片匹配等優點,因而成為一種理想的高密度集成用主導基板。

LTCC金屬外殼封裝基板樣品
HTCC即高溫共燒結陶瓷,HTCC基板具有機械強度高、化學性能穩定、布線密度高等諸多優點,廣泛應用于高可靠、高集成度的微系統封裝。提高陶瓷基板的布線密度、縮小陶瓷基板的最小特征尺寸不僅能提高陶瓷封裝密度,而且有利于進一步提高微系統的集成度。在電子封裝領域,多層高溫共燒氧化鋁陶瓷外殼與薄膜封裝基板由于各自的特點都有較為廣泛的應用。
優勢多多,機遇多多
隨著電子產品向小型化、輕量化、高性能化方向發展,半導體封裝技術面臨著前所未有的挑戰與機遇。
電氣性能優勢。LTCC的陶瓷材料具有優良的高頻高Q特性,能夠有效減少信號傳輸過程中的損耗和失真,特別適合用于高頻通信領域的半導體封裝。HTCC的低介電常數和低介電損耗特性,使其在高速信號傳輸方面表現出色。在高性能計算芯片封裝中,HTCC能夠降低信號傳輸延遲,提高芯片的運算速度和數據處理能力,滿足大數據處理和人工智能運算對芯片性能的苛刻要求。
熱性能優勢。LTCC技術制備的產品具有較好的熱傳導性,能夠快速將芯片產生的熱量散發出去,有效降低芯片的工作溫度。HTCC技術由于其高溫燒結形成的致密結構,具有優異的熱穩定性,能夠在高溫環境下保持封裝性能的穩定。
集成化優勢。LTCC技術能夠將多種無源元件,如電容、電阻、電感等,以及芯片集成在一個封裝內,減少了外部連接線路,提高了電路的集成度和可靠性;HTCC技術同樣具備良好的集成化能力,能夠在多層陶瓷基板上實現高密度的布線和芯片集成。
LTCC和HTCC仍面臨眾多挑戰
LTCC技術的工藝過程較為復雜,涉及多個精細的步驟,這給其大規模應用帶來了一定的挑戰。首先,我國在高頻低損耗低溫共燒陶瓷介質材料生產方面依然落后于國外發達國家,目前我國LTCC瓷粉批次穩定性差,沒有量產能力,與銀電極漿料材料匹配性差,因此,國產瓷粉的需求量也不足,不能形成規模生產。在高性能LTCC陶瓷粉和生瓷帶方面,尤其是5G通信器件應用的材料目前在國內近乎空白。其次,專用設備的缺乏,使得生產成本不斷攀升。
HTCC技術的高溫燒結工藝是其面臨的主要挑戰之一,在1600℃左右的高溫下進行燒結,對設備的要求極高,不僅需要專門的高溫燒結爐,而且設備的維護成本和能耗都較高。同時,因其共燒溫度較高,使得金屬導體材料的選擇受限,而且會大大增加其成本。此外,高溫環境下對陶瓷基板與金屬化層之間的結合強度也有較高的要求,如果結合不牢固,在后續的使用過程中可能會出現金屬化層脫落等問題,降低封裝的可靠性。
LTCC和HTCC技術憑借其在電氣性能、熱性能和集成化等方面的顯著優勢,在半導體封裝領域迎來了諸多機遇,尤其是在高性能計算芯片、5G 通信芯片以及傳感器芯片等封裝應用中展現出巨大的潛力。然而,不可忽視的是,這兩種技術在工藝復雜性、成本以及與其他封裝技術的競爭等方面面臨著嚴峻的挑戰。
中國粉體網將于2025年5月13日在江蘇昆山舉辦“第四屆半導體行業用陶瓷材料技術大會”,屆時,來自中國電子科技集團公司第二研究所的高級工程師陳曉勇將帶來題為《LTCC和HTCC在半導體封裝中面臨的機遇與挑戰》的報告,報告將重點闡述其在LTCC工藝方面所取得科研成果,梳理了目前LTCC材料國產化進程,同時匯報在HTCC技術方面取得的進展情況。面對人工智能、大數據、5G/6G移動通信和新能源等需求牽引和先進封裝技術迭代帶來的市場沖擊,LTCC和HTCC將面臨巨大的機遇與挑戰,并展望未來LTCC/HTCC技術發展方向。

報告老師簡介
陳曉勇,高級工程師,中國電子科技集團公司第二研究所制造部專家。多年來從事 LTCC 和 HTCC 工藝技術及封裝技術研究,承擔多項重點型號產品的研制工作,具有豐富的多層陶瓷產品開發及生產經驗,參與編制多項多層共燒陶瓷行業標準。
來源:
于斐等:基于HTCC和薄膜工藝的微系統封裝基板制備技術
李建輝等:LTCC封裝技術研究現狀與發展趨勢
(中國粉體網編輯整理/空青)
注:圖片非商業用途,存在侵權告知刪除


















